三星发布业界首个12层3D-TSV芯片封装工艺 此前最大仅为8层
三星宣布成功开发出界首个12层3D-TSV(直通硅通孔)技术。这是业界首个将3D TSV封装推进到12层的工艺,而此前最大仅为8层。
3D-TSV最多用在HBM显存上,这种技术通过芯片内部的打孔填充金属导电材料实现多层芯片互联,其速度更快,密度更高。三星此次公布的12层DRAM封装工艺需要在720微米厚的芯片上打超过60000个TSV孔,这些孔的尺寸仅为人头发丝的二十分之一。
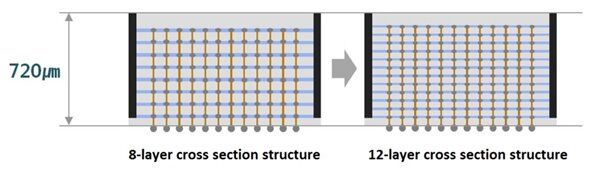
相比于8层HBM2,其芯片厚度相同,但是能够增加DRAM容量。厂商也无需调整系统配置。三星相关负责人表示,随着AI、高性能计算等领域的高速发展,确保超高性能存储器所有复杂性的封装技术正在变得越来越重要。而伴随着摩尔定律达到极限,3D-TSV所扮演的角色将越来越关键。我们希望站在这一最新芯片封装技术的最前沿。
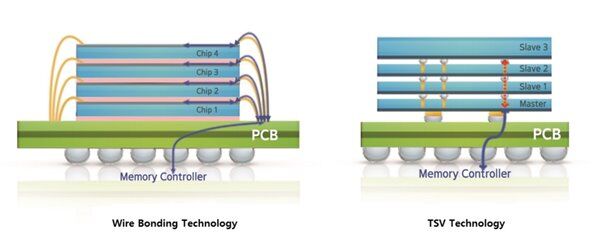
标签:
相关阅读
精彩推荐
阅读排行
相关词
- 天天最资讯丨应急管理部:今年以来生产安全事故起数和死亡人数持续下降 但重特大事故有所反弹
- 微动态丨威高骨科:脊柱、创伤、关节三大领域全部集采并落地执行
- 康泰医学:暂无脑机接口相关产品
- 士兰微:65亿定增获证监会批文 IDM龙头加速汽车芯片产品升级
- 李云泽:下好风险前瞻防控先手棋 以更加主动态度应对风险隐患-全球今亮点
- 全球热讯:中级经济师《金融》每日一练(2023.06.08)
- 腾讯《无畏契约》国服今日终测 20名英雄爽玩 天天报资讯
- 永远杀不完 任天堂发布《塞尔达》历代总BOSS加农集锦_焦点速读
- 世界新资讯:君禾股份:未来预期随着海外库存消耗及消费市场逐步复苏 水泵主业会呈现复苏反弹
- 2023山西太原市古交市招聘社区专职社工体检和考察公告_天天时快讯
- 易纲:坚决把绿色金融工作摆在突出位置,实现“3060”目标需要胡萝卜加大棒
- 2023年山东泰安肥城市城市社区专职工作者招录进入面试范围人员递补名单(第三批)_时讯
- 每日看点!隔夜SHIBOR报1.3390% 下降6.50个基点 7天SHIBOR报1.8500%
- 世界快播:华菱钢铁:目前废钢资源相对稀缺成本较高,长流程炼钢更具经济性
- 全球消息!易会满:进一步打通痛点堵点,为机构投资者入市创造更加有利环境
- 《神秘岛》开发商新作《苍穹乾坤》使用AI辅助开发 引众筹者不满
- 天天头条:五大行再次下调存款利率
- 客人去哪了?五一后各地餐饮生意直线下滑,突然就没人了
- 当前快看:理想汽车在青岛成立销售公司
- 潘功胜:中国稳健金融周期为经济和金融市场运行提供适宜环境
- 美国社交电商再起波澜:TikTok商城开张,Meta却要闭门做生|今日快看
- 世界快资讯:上海再保险“国际板”正式启动
- 特别好评RPG游戏《恐怖的世界》 完整版10月19日上线|环球精选
- 易会满:持续加大对伪私募、地方交易场所等重点领域风险的整治
- 十元店重回巅峰:新穷人与日本1990s
- 每日快报!教育股震荡走低 国新文化跌超8% 荣信文化跌逾7%
- 全球快讯:央行潘功胜:人民币债券具有良好的投资组合分散化价值
- 国产大飞机开启常态化商业运行:C919带动产业链一起飞 市场规模有望达万亿元量级
- U盘安装系统时蓝屏怎么解决 全球头条
- ROG蓝屏后该采取什么解决方法来重启 世界快报
- 中国地震局:国家地震烈度速报与预警工程已完成主体建设任务 焦点讯息
- win10启动就蓝屏是怎么回事 全球热点
- 环球头条:华硕笔记本acpi蓝屏该如何解决
- 世界最资讯丨打击违规销售作弊器材行为 海南省市场监管部门多措并举为高考中考保驾护航
- 每日热议!永劫无间蓝屏死机应该如何处理
- KMODE蓝屏出现应该如何处理 全球观热点
- 携程集团发布2023年第一季度财报
- 甘肃省华亭市东华镇市场监管所开展农村夏季食品安全专项检查_环球热资讯
- 深圳市市场监管局总部经济审批服务“全市通办”正式落地
- 解码开化(一) 文旅产业:从“高看一眼”“棋高一招”到“焕然一新”
- 第五届京津冀石墨烯大会在北京房山举办,加速三地产业链深度融合
- 高考期间海南天气如何?未来两天多云有雷阵雨 焦点速读
- 别被“蚊蝇通杀”迷了眼
- 啥是海洋?直播带你一起看 天天快看点
- 内罗毕:低碳和电动交通载具展 天天观速讯
- 环球播报:斯诺克新星赵心童为涉赌遭禁赛道歉
- 《沙石镇时光》:1.0版本发售日期公布!通过“塑造你的未来”预告片为前方的秘密和危险做好准备 世界独家
- 关注眼健康亟须全社会行动起来
- 哈利波特魔法觉醒怎么尊享眉色 尊享眉色方法攻略 环球速看
- 甘肃省华亭市市场监管局多举措保障中高考期间食品安全 环球新动态
- 第19届深圳文博会人气旺 每日快报
- 甘肃省嘉峪关市市场监管局镜铁分局全力保障高考期间食品和特种设备安全
- 河北沙河:太行古村落焕发新活力_天天快播
- 世界百事通!晋陕峡谷遇奇石
- “共建首都跨境电商新生态”系列活动在京启动 每日热门
- 环球看热讯:汉字工坊上班不带饭怎么过 找出9个公司吃的答案分享
- 甘肃省张掖市新墩市场监管所“三力齐发”加强中高考期间特种设备安全保障_环球热推荐
- 快消息!小心,这种眼疾易盯上上班族
- 眼药水怎样使用才正确
- 当前讯息:机器人:公司基本实现了35kg以下新款机器人减速器的国产化替代
- 华菱钢铁:钢材产品在新能源新材料领域需求前景将持续向好-天天通讯
- 今早发布!雷雨!_天天即时
- 全球快报:云顶之弈s9暗影岛格温阵容攻略 s9赛季暗影岛格温阵容搭配
- 江苏“智造”夯牢实体经济“家底”
- 加拿大野火烟尘飘至美国 部分地区被烟尘笼罩
- 【环球时快讯】文字玩出花无法原谅怎么过 无法原谅十二处细思极恐在哪
- 环球快播:百亿授信!民生银行与协鑫集团达成全面战略合作
- 前5月外贸保持稳定增长 制造业转型升级塑造出口新动能
- 简讯:江苏油田页岩油累产突破4万吨
- 让城市成为“开放的艺术馆”(金台随笔) 视点
- 易会满:适时出台资本市场进一步支持高水平自立自强的政策措施 全球报道
- 【全球聚看点】河南麦收进度过八成 夏播已完成近五成
- 今起,在锡启幕!
- 两大国际组织上调中国2023年经济增长预期
- 仲景食品:公司产品以国内销售为主 出口业务占比较小-每日速看
- 天天速递!U盘装系统进入PE蓝屏该采取什么解决方法
- 充满算计!日美澳在南太铺光缆,日媒炒“抗衡中国影响力” 焦点热门
- 重点聚焦!力箭一号火箭的专属发射工位长什么样?
- 袁明辉:拍摄下来记录下来用自然摄影留住那些美好
- 扫码支付已在国内迅速发展普及 刷掌支付是否还有市场前景
- “去风险”成脱钩新马甲
- 环球微资讯!360qpesv.sys导致蓝屏该采取什么解决方法
- 【新要闻】北海市海城区地角街道辖区率先完成第二季度食品安全“两个责任”包保工作
- 国家开发银行前5个月发放交通领域贷款2687亿元
- 当前视点!带火原料药企,马斯克加持的“减肥神药”又火了
- 什么是股份制企业?股份制企业和私营企业的区别有哪些?
- 怎么才能正确安装python39.dll
- 全球连线|对两国合作机遇充满期待——洪都拉斯各界热议中国驻洪使馆开馆
- 兰州新区召开第二季度落实食品安全“两个责任”推进会议
- 民泰银行绍兴分行创新产品助共富系列① | 动产融资业务,为民播下“共富”希望-世界实时
- 【世界快播报】我国外贸连续4个月保持正增长
- 偷渡罪一般判多少年?偷渡人员怎么正规回国?
- 吉利雷达以“真乘用化”撬动市场,5月销售1016台创历史新高 焦点资讯
- 故意伤害致人死亡如何处罚?故意伤害致死赔偿多少?
- “6·6”全国爱眼日公益讲座在京举办
- 上古诸神:卡牌对战官网在哪下载 最新官方下载安装地址 环球热推荐
- 天天头条:电脑中缺失alrsvc.dll文件应该怎么处理
- 赡养费标准是什么?不给赡养费最严重的后果有哪些?
- 只允许跟院方合作民营救护车辆进入?医院回应
- 涉案金额959万元!海口曝光9家定点医疗机构
- 世界快播:如何解决电脑端丢失rasmans.dll提示问题
- 微资讯!江西省新余市市场监管局:强化建材质量监管 守牢质量安全防线
- 【快播报】警惕“负首付”骗贷
- 财产税有哪些税种?所得税和财产税的区别有哪些?
- 高考第二天部分地区已公布查分时间 胜利在望,加油少年!|全球快看点
- 青海省海西州四项措施为“中高考”保驾护航_每日看点
- 嫖娼拘留多少天?初次涉黄拘留几天?
- 青海省市场监管局发布中高考期间食品安全消费提示 天天热门
- 浙江金华婺城区:天然富硒,“硒”望之旅
- mtfutils.dll缺失如何恢复
- 忘了车限号开了一天罚多少钱?郑州限行免罚有几次机会?
- 焦点快播:网红化妆大师官网在哪下载 最新官方下载安装地址
- 动态:量子密钥分发攻防研究获重要进展
- 什么是违法所得?违法所得和非法财物的区别有哪些?
- 仙迹之九州神剑官网在哪下载 最新官方下载安装地址|今热点
- 工程预付款是怎么规定的?工程预付款为什么要扣回?
- 种一颗牙便宜多少钱?海南打出种植牙降价“组合拳”
- 劳动合同法第38条是什么内容?公司不辞退故意调岗怎么赔偿?
- 无证驾驶怎么处罚?无证驾驶会被马上拘留吗?
- 当前时讯:生存冒险游戏《血清》新预告 拥有4人合作模式
- 天天观热点:岭南街道构建“一网二联三队伍”服务模式,为社区长者健康保驾护航
- 通信业全力保障高考|莘莘学子逐梦未来 通信业全力护航
- 焦点观察:华为品质宽带智能运维系统荣获CAICT光接入网L3.5等级认证
- 青海省启动“企业商业秘密保护能力提升服务月”活动-天天速看
- 黑龙江省北安市市场监管局着力打造“帮您办”服务品牌|动态焦点
- 非遗 | 高校留学生走进安徽文旅扶点-环球通讯
- 今日快看!FPS游戏《无畏契约》国服今日终测 删档充值返利
- 环球最新:黑河联通多措并举提升廉洁文化教育质效
- 每日视点!语文名师点评AI高考作文:百度搜索AI伙伴优于New Bing、ChatGPT
- 国家金融监督管理总局李云泽:正式启动上海再保险“国际板”-环球快看点
- 全球报道:重庆油菜喜获丰收 总产量实现连续16年增长
- 冒险游戏《血清》发布实机视频 支持简体中文 四人联机
- 全力保障高考通信畅通,重庆电信在行动!_环球速读
- 《无人深空》发布季节性更新“奇点”预告视频 现已正式上线-环球微速讯
- 世界殿堂级名团重返中国舞台 玛莎·葛兰姆现代舞团尽展风采 观速讯
- 上海移动获得DC-Tech数据中心智能建造最高等级认证 当前快讯
- 戴尔电脑开机后蓝屏重启应该怎么应对
- 电视剧《照亮你》在都市类型中铺展新的叙事面向 世界要闻
- 黑白琴键抒写长三角风情 全球新要闻
- 上海世纪出版、米哈游、东方明珠新媒体上榜
- 电脑提示vcomp140.dll文件丢失的解决方法|环球新要闻
- 世界今热点:切实保护金融消费者合法权益
- 全球快报:电脑蓝屏nv1ddmkm.sys怎么办
- “拆楼”式装修必须叫停
- 世界今日讯!李云泽:下好风险前瞻防控先手棋,以更加主动态度应对风险隐患
- 湖北馆展品超5000件:五大“重器”显实力 五类“非遗”溢楚风_今日看点
- 国家金融监督管理总局李云泽:监管体制改革是金融改革的重要一环 天天快资讯
- 公安部交管局公布近期三轮车肇事肇祸典型交通事故案例
- 网传重组人生长激素进浙江集采 长春高新连夜召开电话会回应
- 当前通讯!传记文学《灵魂的旋律:我的父亲刘炽》:再现作曲家刘炽艺术人生













































